如何判断锡膏的印刷性和润湿性
来源:优特尔锡膏 浏览: 发布时间:2025-06-07 
判断锡膏印刷性和润湿性的方法:
判断印刷性
外观检查:观察印刷后的锡膏图形,边缘应清晰、光滑,无塌边、锯齿状或拖尾现象,锡膏量均匀一致,能完整地填充焊盘,无缺料或多料情况。
厚度测量:使用锡膏测厚仪等工具测量印刷锡膏的厚度,不同的电路板和元器件对锡膏厚度有不同要求,如0402封装元件通常要求锡膏厚度在0.08 - 0.12mm,若实际厚度与设计要求偏差在±10%以内,说明印刷性较好。
脱模效果:在印刷过程中,观察锡膏从钢网转移到电路板上的脱模情况。
好的印刷性表现为锡膏能快速、完整地从钢网孔中脱离,钢网表面残留的锡膏少,且电路板上的锡膏图形与钢网孔的形状和尺寸一致。
印刷速度和压力:合适的印刷性允许在一定的印刷速度和压力范围内,保持稳定的锡膏转移效果。
一般来说,当印刷速度在30 - 60mm/s,印刷压力在3 - 5kg/cm²时,能印刷出质量良好的锡膏图形,说明该锡膏的印刷性较好。
判断润湿性
焊点外观:焊接后良好的润湿性会使焊点表面光滑、光亮,呈半月形,与焊盘和元器件引脚之间的接触角较小,一般小于30°,且焊点饱满,无虚焊、漏焊等缺陷。
扩展率测试:将一定量的锡膏放置在标准测试板的焊盘上,经过回流焊接后,测量锡膏在焊盘上的扩展面积与原始面积的比值,扩展率在70% - 90%之间通常表示润湿性良好。
润湿时间:通过焊接过程中的实时监测设备,测量锡膏从接触焊盘到完全润湿并铺展的时间。
一般来说,润湿时间越短,说明润湿性越好,通常要求润湿时间在1 - 3秒内。
金相分析:对焊点进行金相切片分析,观察锡膏与焊盘、元器件引脚之间的界面结合情况。
良好的润湿性会使界面形成均匀、连续的金属间化合物层,无明显的缝隙或空洞。
影响锡膏印刷性和润湿性的因素主要方面;
锡膏自身特性
合金成分:不同的合金成分会影响锡膏的熔点、表面张力等,进而影响润湿性。
例如,Sn - Ag - Cu合金比Sn - Cu合金的润湿性更好。
助焊剂:助焊剂的活性、成分及含量对润湿性影响很大。
活性高的助焊剂能更好地去除焊件表面的氧化物,增强润湿性。
同时,助焊剂的粘度、触变性等也会影响锡膏的印刷性,合适的粘度和触变性可使锡膏在印刷时容易脱模,且保持形状。
颗粒大小及形状:锡粉颗粒小,印刷性好,但过小易氧化;颗粒形状不规则会影响锡膏的流动性和填充性,进而影响印刷性和润湿性。
一般锡粉颗粒为球形且粒径分布均匀时,锡膏的综合性能较好。
印刷工艺参数
印刷速度:速度过快,锡膏来不及填充钢网孔,会导致锡膏量不足、印刷不完整;速度过慢,会使锡膏在钢网上停留时间过长,易干燥,影响印刷性。
印刷压力:压力过大,会使钢网与电路板之间的锡膏被过度挤压,造成锡膏图形不清晰、边缘不整齐;压力过小,锡膏不能充分转移到电路板上,影响印刷质量。
刮刀角度和硬度:刮刀角度一般在45° - 60°之间,角度越小,印刷压力越大。
刮刀硬度也会影响印刷效果,硬刮刀适用于厚钢网和高粘度锡膏,软刮刀则适用于薄钢网和低粘度锡膏。
电路板和钢网因素
电路板表面特性:电路板焊盘表面的平整度、粗糙度、清洁度等会影响锡膏的润湿性。表面平整、光滑且清洁的焊盘,有利于锡膏的铺展和润湿。
钢网设计与制造:钢网的开口尺寸、形状、厚度以及开孔率等都会影响锡膏的印刷性。开口尺寸应根据焊盘大小和元器件类型合理设计,开口形状应保证锡膏能顺利脱模。
钢网厚度要与锡膏量需求相匹配,开孔率高有利于锡膏转移,但过高可能导致锡膏坍塌。
环境因素
温度:环境温度过高锡膏中的助焊剂易挥发,使锡膏干燥影响印刷性和润湿性;温度过低,锡膏粘度增大,流动性变差,也不利于印刷和润湿一般印刷环境温度控制在22℃ - 25℃为宜。
湿度:湿度过高,锡膏易吸收水分,导致焊接时产生气孔、飞溅等缺陷,影响润湿性;湿度过低,锡膏中的溶剂挥发过
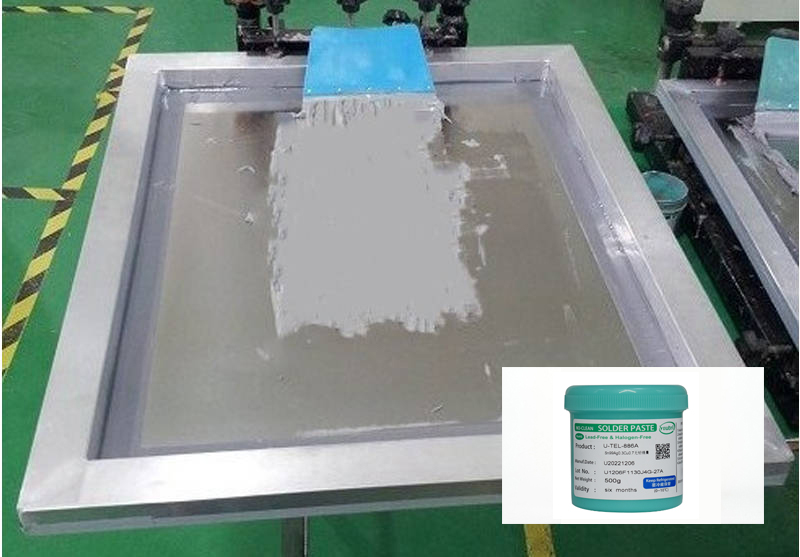
快,会使锡膏变硬,影响印刷性通常湿度保持在40% - 60%较为合适。
上一篇:如何选择一款优质品牌锡膏
下一篇:水溶性锡膏和免清洗锡膏的焊接效果有所不同
