锡膏常见问题排查:虚焊、桥连与锡珠的解决办法
来源:优特尔锡膏 浏览: 发布时间:2025-07-11 
锡膏在印刷、焊接过程中出现的虚焊、桥连、锡珠是最常见的质量问题核心原因与锡膏性能、印刷参数、PCB/元件状态及焊接工艺密切相关。
从原因分析和针对性解决办法两方面详细说明:
虚焊(Cold Solder Joints)
表现:焊点表面粗糙、不饱满,与焊盘/元件引脚结合不牢固,易脱落;显微镜下可见焊点与基底间存在缝隙或氧化层。
核心原因;
1. 锡膏本身问题
锡膏变质:助焊剂活性衰减(如过期、储存不当导致活性剂失效),无法去除焊盘/引脚的氧化层;
焊粉氧化:焊粉颗粒表面形成氧化膜(锡膏开封后暴露时间过长、回收锡膏反复使用),焊接时无法熔融浸润。
2. 印刷参数异常
锡膏印刷量不足:钢网开孔过小、印刷压力过大(导致锡膏被刮除过多),或锡膏黏度太高(流动性差,无法填满开孔),导致焊点锡量不足,无法形成有效连接。
3. PCB/元件引脚污染或氧化
焊盘或元件引脚有氧化层(存储环境潮湿、未做防氧化处理)、油污/指纹污染,助焊剂无法穿透污染物,导致焊锡无法浸润。
4. 焊接工艺参数错误
焊接温度过低或时间过短:焊锡未完全熔融(低于锡膏熔点),或助焊剂未充分发挥活性(预热不足,活性剂未激活);
升温速率过快:助焊剂在焊锡熔融前已提前挥发,失去去除氧化层和辅助浸润的作用。
解决办法;
1. 锡膏管控
检查锡膏状态:确认未变质(无结块、分层,活性正常),使用在保质期内的锡膏;开封后4小时内用完,避免反复回收使用。
选择匹配活性的锡膏:针对氧化严重的PCB/元件,选用中高活性(RMA/RA级)锡膏。
2. 优化印刷参数
调整钢网:根据焊盘尺寸设计开孔(开孔面积≈焊盘面积的80%~90%),确保锡膏量充足;定期清洁钢网,避免开孔堵塞。
校准印刷参数:印刷压力以“刚好刮净钢网表面锡膏”为宜(通常5~10N),速度30~50mm/s,保证锡膏均匀覆盖焊盘。
3. 清洁与预处理
PCB/元件:用异丙醇清洁焊盘和引脚,去除氧化层(轻微氧化可通过细砂纸轻擦);对长期存放的PCB进行烘烤(120℃/2小时)除潮。
4. 调整焊接曲线
预热阶段:温度80~120℃,时间60~120秒(根据PCB厚度调整),确保助焊剂充分活化、挥发水汽,避免升温过快(≤3℃/s)。
回流阶段:峰值温度比锡膏熔点高20~30℃(如Sn63Pb37熔点183℃,峰值200~210℃),保温时间30~60秒,保证焊锡完全熔融浸润。
桥连(Bridging),
表现:相邻焊盘(尤其是细间距引脚,如QFP、BGA)之间的锡膏熔融后连成一片,形成短路。
核心原因;
1. 锡膏印刷过量或偏移
钢网开孔过大/变形:开孔尺寸超过焊盘(如间距≤0.5mm的引脚,开孔宽度>焊盘宽度的90%),或钢网张力不足导致开孔偏移,印刷时锡膏溢出至焊盘外。
印刷参数不当:印刷压力过小(锡膏未刮净,残留过多)、速度过慢(锡膏堆积),或锡膏黏度太低(流动性过强,易扩散)。
2. 锡膏流动性异常
锡膏中助焊剂比例过高(或溶剂未充分挥发),导致焊接时流动性过强,锡膏向相邻焊盘扩散。
3. 焊接曲线不合理
预热温度过低或时间过短:助焊剂未充分挥发,焊接时因高温产生“爆沸”,推动锡膏向四周扩散;
升温速率过快:锡膏瞬间熔融,流动性失控。
解决办法;
1. 优化钢网设计
减小开孔尺寸:细间距(≤0.5mm)焊盘的开孔宽度≤焊盘宽度的80%,长度略短于焊盘(避免两端溢出);开孔边缘做圆角处理,减少锡膏堆积。
检查钢网状态:定期校准钢网张力(避免变形),清理开孔内残留锡膏(用钢网清洁剂+软毛刷),防止开孔堵塞导致局部锡膏过多。
2. 调整印刷参数
控制印刷量:压力调整至“钢网与PCB贴合紧密,刮刀轻刮后表面无残留锡膏”;速度50~80mm/s(细间距元件适当加快,减少锡膏堆积)。
选用合适黏度锡膏:细间距元件优先选择中高黏度锡膏(黏度100~200Pa·s,具体按设备推荐),减少印刷后流动。
3. 控制锡膏状态
开封后充分回温(25℃/2小时),避免因温差导致吸潮;搅拌均匀(自动搅拌2分钟),确保焊粉与助焊剂混合均匀,减少流动性波动。
4. 优化焊接曲线
延长预热时间:预热温度100~130℃,时间120~180秒(根据PCB层数调整),确保助焊剂充分挥发(挥发量约30%~40%)。
降低升温速率:从预热到回流的升温速率控制在1~2℃/s,避免锡膏瞬间熔融。
锡珠(Solder Balls),
表现:在焊盘周围或PCB绝缘区域出现细小锡球(直径0.1~0.5mm),可能导致短路或可靠性隐患。
核心原因;
1. 印刷时锡膏污染
钢网与PCB对位不准,或PCB焊盘边缘有毛刺,导致印刷时锡膏被挤压到焊盘外的绝缘层上;
钢网底部残留锡膏(未清洁),印刷时转移到PCB非焊盘区域,形成“残留锡膏”,焊接后凝固成锡珠。
2. PCB/钢网清洁不足
PCB焊盘周围有氧化层、油污或残留助焊剂,导致锡膏在非焊盘区域无法被助焊剂“排斥”,反而附着凝固;
钢网开孔内壁有残留锡膏(未彻底清洁),印刷时不断释放细小锡膏颗粒到PCB表面。
3. 锡膏量过多或特性异常
锡膏印刷过量(尤其是焊盘边缘),多余锡膏被挤压到绝缘层;
锡膏中焊粉颗粒度过细(或分布不均),导致焊接时易形成小锡珠;助焊剂活性不足,无法约束锡膏在焊盘内流动。
4. 焊接曲线问题
预热阶段升温过快:助焊剂挥发速度超过锡膏熔融速度,产生“飞溅”,将细小锡膏颗粒溅到绝缘层;
峰值温度过高:焊锡过度熔融,流动性过强,溢出焊盘形成锡珠。
解决办法;
1. 加强清洁与对位
印刷前清洁:用无尘布蘸异丙醇擦拭PCB表面(尤其是焊盘周围)和钢网底部,确保无油污、残留锡膏;钢网每次使用后用专用清洁剂超声清洗,去除开孔内残留。
精准对位:调整印刷机对位精度(误差≤0.05mm),确保钢网开孔与焊盘完全对齐,避免边缘错位导致锡膏外溢。
2. 控制锡膏量与特性
优化开孔:焊盘边缘的开孔做“缩边”处理(比焊盘小0.1~0.2mm),减少边缘锡膏量;细间距元件选用颗粒度较粗的锡膏(如Type 4,避免细颗粒飞溅)。
锡膏回温与搅拌:回温至室温(25℃)后搅拌3分钟,确保焊粉与助焊剂均匀混合,避免因分散不均导致局部流动性异常。
3. 优化焊接曲线
平缓预热:预热温度分阶段提升(如80→100→120℃),总时间150~200秒,让助焊剂缓慢挥发(挥发速率≤1%/秒),减少飞溅。
控制峰值温度:比锡膏熔点高15~25℃(如无铅锡膏SnAgCu熔点217℃,峰值230~240℃),避免过度熔融;保温时间控制在30~45秒,减少锡膏流动溢出。
虚焊、桥连、锡珠的核心解决思路是:控制锡膏状态(活性、黏度、颗粒度)→ 优化印刷参数(量、对位、清洁)→ 匹配焊接曲线(预热、升温、
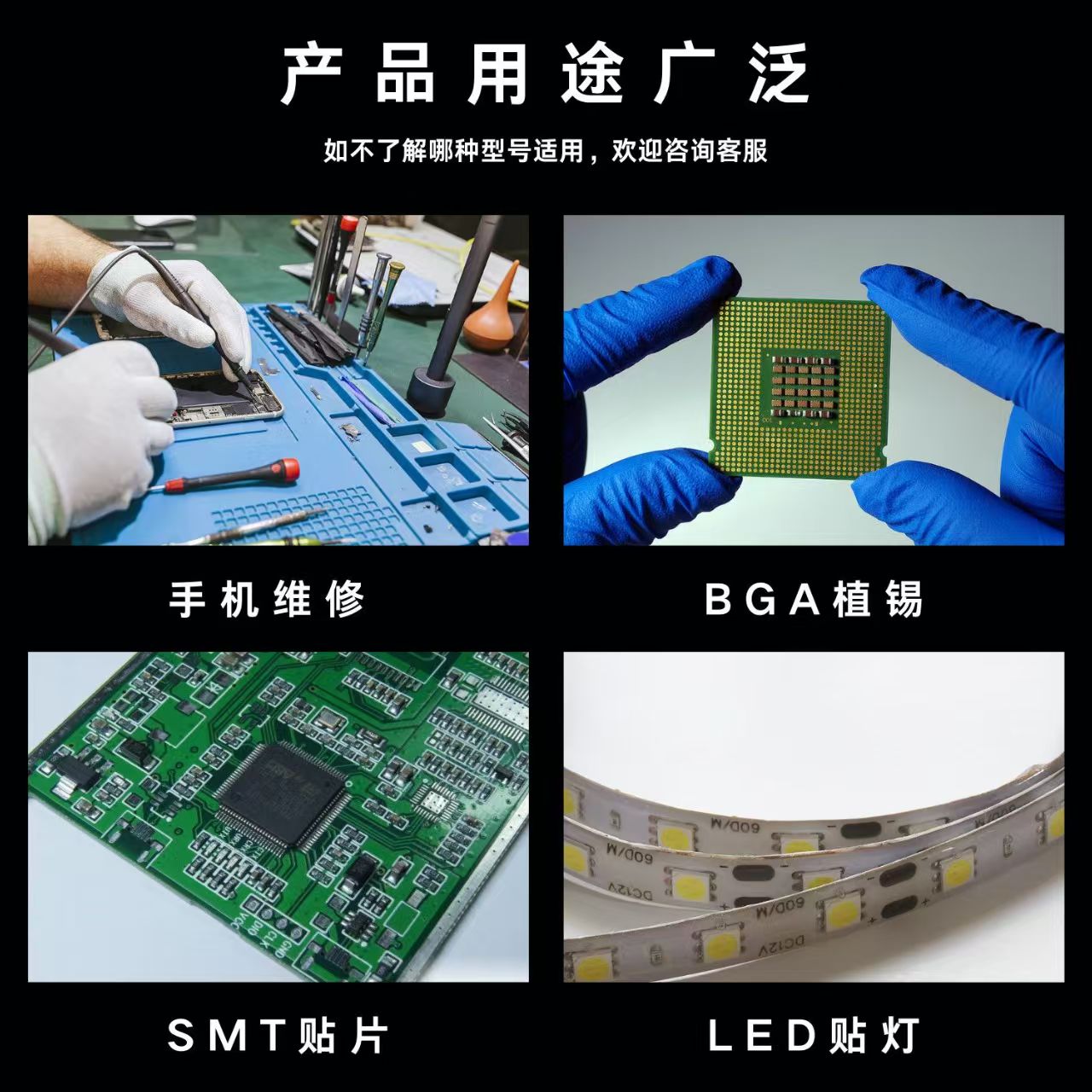
峰值)→ 保证PCB/元件洁净。
实际排查时,可通过“分步验证”(先检查锡膏状态,再调整印刷,最后优化焊接参数)定位根本原因,针对性解决,避免盲目调整。
上一篇:生产厂家详解如何判断锡膏是否已经变质?
下一篇:如何避免锡膏印刷过程中出现虚焊
